
Wafer Saw
- 3 mils to 34 mils thick
- 8 inches wafer diameter
- Si, GaN-on-Si, and SiC
- Auto wafer saw and Ultratech Cleaner with CO2 Re-ionizer to maintain water resistivity of 0.1 to 1 Mohm-cm
- 100% saw through and partial cut
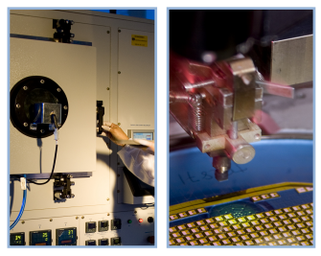
Die and DBC Attach
- Soft and Eutectic solder attach process using belt furnace, vacuum oven and auto die attach (with leaded and leadfree capability)
- Automated Solder Paste application

Wirebond
- Ultrasonic bonding
- Automatic wirebonder; capable for Aluminum wires (1.25 to 20 mils aluminum wire 99.99% or 99.999%)
- Fully automatic equipment, deep access with stitch-bonding
capability.

MOLD (for Discrete Packages)
- Conventional mold die sets with auto-frame loaders (120 to 175 tons capacity)
- Sensor equipped pellet pre-heaters
- Green mold compound technology
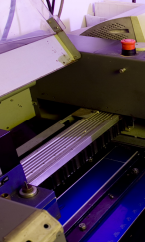
Marking (Discrete Packages)
- Laser engraved marking

Marking (For Module Packages)
- Marking using sticker label
- Computer-based Zebra thermal printer

Trim and Form (For Discrete Packages)
- Dedicated DTFS die sets for plastic packages.
- Hydraulic press (max capacity 1500psi)
- Pneumatic press (max capacity 100psi)